
DUV-VIS-NIR
分光エリプソメータ
SENresearch 4.0platdorm
研究・開発用途に最適
測定スペクトル範囲:190nm〜3500nm
紫外線(190nm)UV領域から、近赤外線(3500nm)NIP領域までの
広い波長領域にわたる範囲で分光スペクトル解析を行うことにより、
被測定物質の光学的諸定数(膜厚・屈折率など)を求めることができます。
近赤外領域測定には�FTIRにより、広帯域なスペクトル分析に於いて
高速且つ高S/N比による測定を可能とします。
測定スペクトル(SENresearch 4.0platformラインナップ)
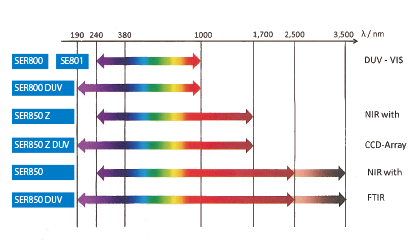
分光エリプソメータの測定項目
*膜厚
・薄膜層 ・単層-多層膜 ・表面-界面ラフネス
*光学定数
・屈折率 ・消衰係数(吸収係数)
*物質特性
・導電性 ・合金組成比 ・層構造(結晶、非晶質、ボイド) ・バンドギャップ
一般仕様
【測定方式】
Step Scan Analyzer(SSA)
PSCA setup
【ディテクタ/スペクトロメータ】
UV-VIS:liner CCD array
NIR(1700nm迄):liner InGAs diode array
NIR(2500/3500nm迄):FT-IR spectrometer
【精度】
Ψ(Psi):45±0.03deg
Δ(Delta):0±0.06deg
【膜厚測定誤差(1σ)】
0.015nm
(SENTECH srandard wafer 100nm SiO2/Si)
【スポットサイズ 】
1.5~3mm
【入射角度】
20~100°
(motorized pyramid goniometer)
40~90°
(manual goniometer)
【測定時間】
UV-VIS:5秒
UV-VIS(fast mode):0.2秒
NIR:10秒(FT-IR)
【サンプルプラットホーム】
直径150~300mm
【用力】
115/230WAC、50-60Hz、600W

In situ用分光エリプソメータ
SE801
エッチングプロセス、成膜プロセス等に於いて
膜厚、光学定数等、In-Situモニタリングが可能です。
一般仕様
【セットアップ】
Step Scan Analyzer、コンペンセーター、高感度CCDアレーセンサー
【測定スポット】
2mm~6mm
【測定時間】
1.5-2.0�秒
for complete(ψ、Δ)spectra(fast mode)
【測定波長】
240~1000nm
(DUV extension 200~1000nm)
【取付フランジ】
ICF70/NW40

赤外分光エリプソメータ
SENDIRA
400cm-1〜6,000cm-1(1.7μm〜25μm)
Infrared spectroscopic ellipsometry
赤外スペクトラム領域での分子振動吸収バンドの解析をすることにより、
薄膜材料の組成分析を行えます。
またFTIR分光エリプソメトリによる材料のキャリア濃度、膜厚(d)、
光学定数(n,k)の測定が決定できる強力な材料解析ツールです。
一般仕様
【測定波長】
1.7μm〜25μm
400cm-1〜6,000cm-1
【測定スポット】
4mm~10mm
【入射角】
40°〜90°(自動)
精度0.005°
【プラットフォーム】
6”-8” diameter
【ソフトウェア 】
spectraRay/3
【用力】
power 115/230VAC,
50/60Hz
|


